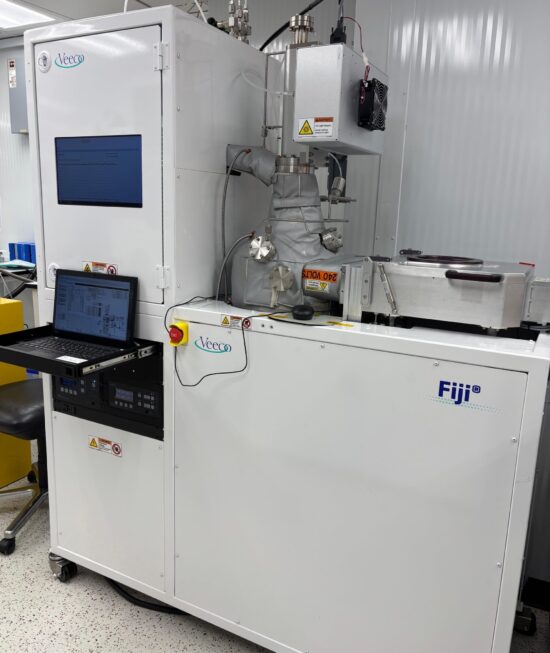
Équipement: Dépôt par couches atomiques (ALD) – Veeco Fiji
Description: Le système Veeco Fiji est une plateforme modulaire de dépôt par couches atomiques (ALD) conçue pour la recherche avancée en couches minces.
Il prend en charge l’ALD thermique, l’ALD assistée par plasma (PEALD) ainsi que le mode Exposure Mode™, offrant une grande flexibilité pour le dépôt de films conformes sur des surfaces planes ou des structures à fort rapport d’aspect.
Grâce à un contrôle précis de l’épaisseur, une excellente uniformité et une compatibilité avec une large gamme de précurseurs et de gaz, le système Fiji est largement utilisé dans les domaines des semi-conducteurs, MEMS, capteurs, énergie et matériaux 2D.
Caractéristiques:
- Matériaux : Al₂O₃, HfO₂
- Température de procédé : Jusqu’à 500 °C pour substrats de 200 mm
(Option jusqu’à 800 °C pour substrats de 100 mm) - Source plasma : Source plasma à couplage inductif (ICP) de 300 W
- Uniformité de dépôt : ± 1,5 % pour Al₂O₃ thermique et plasma (1 sigma)
- Gestion des précurseurs : Jusqu’à 6 lignes de précurseurs, chauffées individuellement jusqu’à 200 °C, compatibles avec des précurseurs gazeux, liquides et solides
- Lignes de gaz plasma : Jusqu’à 6 lignes compatibles avec Ar, N₂, O₂, H₂ et ozone
- Contrôle de l’épaisseur des films : Résolution à l’échelle de l’angström
Équipement:Évaporateur à faisceau d’électrons (E-beam) – BJD-1800
Description: Le Temescal BJD-1800 est un système d’évaporation par faisceau d’électrons de type cloche (bell jar), à profil bas et éprouvé industriellement, utilisé pour le dépôt de films métalliques minces en recherche, développement et production.
Il est largement utilisé pour les procédés de revêtements optiques et électroniques.
Caractéristiques:
- Fonction: Système de dépôt physique en phase vapeur (PVD), principalement configuré en évaporation par faisceau d’électrons, avec possibilité de configuration en évaporation thermique ou pulvérisation cathodique (sputtering).
- Chambre: Chambre en acier inoxydable refroidie à l’eau, de 18 pouces (457 mm) de diamètre, avec dôme articulé à ressort pour un accès facile et un chargement simplifié des substrats.
- Système de vide : Équipé typiquement d’une pompe cryogénique CTI Cryo-Torr 8, permettant d’atteindre un vide poussé de l’ordre de 10⁻⁷ à 10⁻⁸ Torr, complété par une pompe primaire mécanique.
- Source E-beam: Canon à électrons avec creuset rotatif multi-poches (généralement 4 ou 6 positions), permettant le dépôt séquentiel de différents matériaux sans rupture de vide.
- Matériaux déposés: Compatible avec une large gamme de matériaux, notamment: Aluminium (Al), Titane (Ti), Or (Au), Chrome (Cr) et Silicium (Si).
- Contrôle: Systèmes généralement équipés de contrôleurs de procédé automatisés (ex. : Inficon I/C5 ou XTC/2) permettant un contrôle précis de la vitesse de dépôt et de l’épaisseur des films, ainsi que de contrôleurs programmables de balayage.
- Gestion des substrats: Compatible avec différents formats de substrats jusqu’à des wafers de 6 pouces, avec options de rotation plane ou planétaire pour assurer une excellente uniformité de dépôt.

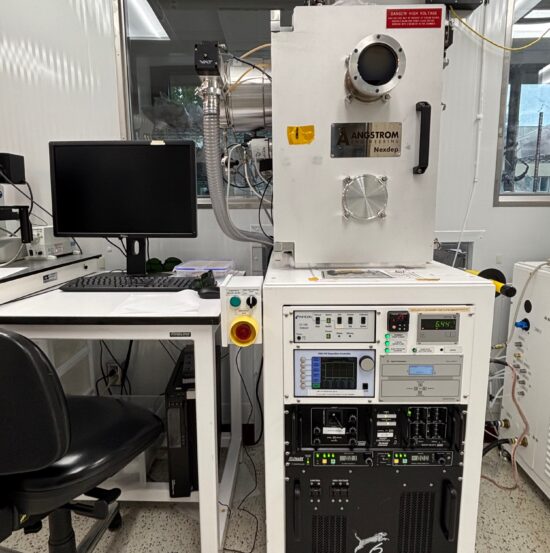
Équipement:Évaporateur à faisceau d’électrons (E-beam) – Nexdep
Description: Le système Angstrom Nexdep est un outil de dépôt physique en phase vapeur (PVD) utilisé pour la réalisation de films minces par évaporation thermique ou évaporation par faisceau d’électrons.
Flexible et configurable, il est particulièrement adapté aux environnements de recherche et développement, avec un contrôle automatisé convivial des procédés de dépôt. Le système peut également être intégré à une boîte à gants (glovebox) pour des opérations sous atmosphère contrôlée.
Il permet le traitement de substrats de grande taille ainsi que le dépôt de multiples matériaux au cours d’un même cycle.
Caractéristiques:
- Configuration flexible: Source E-beam avec creuset multi-poches permettant le dépôt de différents matériaux
- Contrôle automatisé: Fonctionnement automatisé du vide et contrôle du taux de dépôt, avec interface PC pour la programmation des recettes et l’acquisition des données
- Gestion des substrats: Compatible avec une large gamme de tailles de substrats, avec options telles que le chauffage
- Dépôt multicouche: Possibilité de déposer plusieurs couches de matériaux différents au cours d’un même cycle sous vide
- Matériaux déposés: Compatible avec une grande variété de matériaux, notamment: Aluminium (Al), Titane (Ti), Or (Au), Chrome (Cr) et Silicium (Si)
Équipement: Sputtering (pulvérisation cathodique) – Angstrom Amod
Description: Le système Angstrom Amod est un outil de dépôt physique en phase vapeur (PVD) basé sur la pulvérisation cathodique (sputtering), conçu pour le dépôt de films minces métalliques et diélectriques en recherche, développement et production pilote.
Modulaire et flexible, il permet le dépôt contrôlé de couches minces avec une excellente uniformité et une bonne reproductibilité. Il est particulièrement adapté aux applications en microfabrication, optique et électronique.
Caractéristiques:
- Gestion des substrats: Compatible avec différentes tailles de substrats (jusqu’à wafers), avec options de rotation et de chauffage pour améliorer l’uniformité et l’adhérence
- Fonction: Système PVD par pulvérisation cathodique (DC et/ou RF selon configuration), adapté aux matériaux conducteurs et isolants
- Chambre: Chambre sous vide en acier inoxydable, conçue pour un environnement propre et stable, avec accès facilité pour le chargement des substrats
- Système de vide: Vide poussé typiquement dans la gamme 10⁻⁶ à 10⁻⁷ Torr, avec pompe primaire et pompe turbomoléculaire
- Sources de dépôt: Cibles multiples (multi-target), permettant le dépôt de différents matériaux sans rupture de vide
- Matériaux déposés: Métaux et diélectriques, incluant Aluminium (Al), Titane (Ti), Or (Au), Chrome (Cr), Silicium (Si), oxydes et nitrures
- Contrôle: Contrôle automatisé des paramètres de dépôt (puissance, pression, débit de gaz, taux de dépôt), avec interface programmable pour recettes
- Dépôt multicouche: Possibilité de réaliser des empilements multicouches complexes dans un même cycle de dépôt
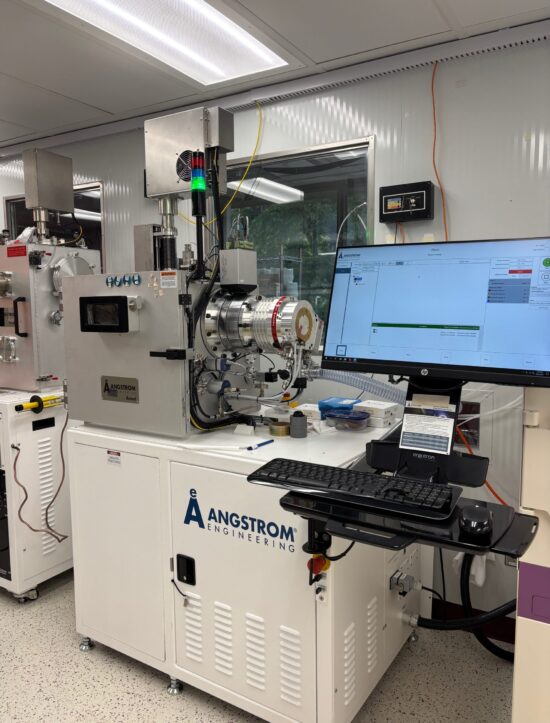
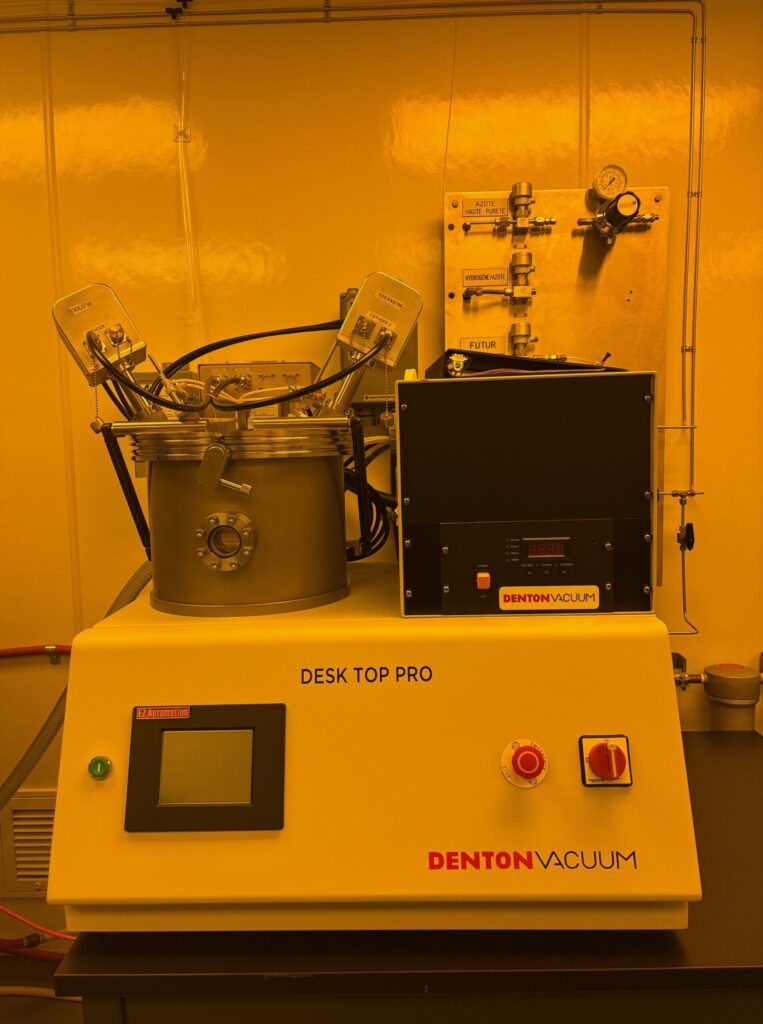
Équipement: Sputtering (pulvérisation cathodique) – Denton Desktop Pro
Description: Le Denton Desktop Pro est un système compact de pulvérisation cathodique magnétron sous vide poussé, conçu pour la recherche et développement.
Il offre une grande polyvalence pour le dépôt de métaux, diélectriques et matériaux magnétiques, avec une excellente uniformité des films. Grâce à ses configurations DC et RF, ses temps de pompage rapides et son faible encombrement (moins de 36 pouces de largeur), il est idéal pour les laboratoires nécessitant des dépôts reproductibles et de haute qualité.
Caractéristiques:
- Conception compacte:Format de paillasse nécessitant moins de 36 pouces d’espace
- Sputtering polyvalent:Compatible avec alimentation DC (métaux, matériaux magnétiques) et RF (diélectriques, sputtering réactif)
- Vide poussé: Atteint des niveaux de vide de l’ordre de 10⁻⁶ Torr avec des temps de pompage rapides
- Uniformité: Utilisation de magnétrons inclinés et de plateaux rotatifs permettant une uniformité d’épaisseur de ±5 % sur le substrat
- Co-sputtering: Capacité de déposer simultanément plusieurs matériaux pour la réalisation d’alliages ou de structures complexes
- Applications R&D: Idéal pour la préparation d’échantillons MEB (ex. : dépôt d’or), la recherche et la fabrication de films minces fonctionnels
Équipement: Oxford PlasmaLab System 100 – PECVD (Dépôt chimique en phase vapeur assisté par plasma)
Description:Le système Oxford PlasmaLab 100 PECVD (Plasma-Enhanced Chemical Vapor Deposition) est une plateforme modulaire et polyvalente permettant le dépôt de films minces de haute qualité tels que le dioxyde de silicium (SiO₂), le nitrure de silicium (SiNₓ) et le silicium amorphe (a-Si) à basse température.
Il utilise l’énergie du plasma pour activer les réactions chimiques, ce qui le rend particulièrement adapté aux applications en semi-conducteurs, MEMS et revêtements optiques. Le système intègre des alimentations RF/LF, une large gamme de gaz de procédé et un contrôle précis permettant d’obtenir des films uniformes et à faible contrainte
Caractéristiques:
- Dépôt à basse température: Le plasma fournit l’énergie nécessaire aux réactions, permettant des dépôts à des températures inférieures à celles du CVD thermique (ex. : ~350 °C)
- Polyvalence des matériaux: Dépôt de diélectriques (SiO₂, SiNₓ, SiON), silicium amorphe (a-Si) et, dans certains cas, carbure de silicium (SiC)
- Architecture modulaire: Configuration possible avec loadlocks et chambres de transfert pour une manipulation automatisée, souvent intégrée avec des systèmes ALD
- Génération du plasma: Utilise des alimentations RF (13,56 MHz) et LF (50–460 kHz), permettant un contrôle fin des contraintes des films
- Gestion des gaz: Compatible avec divers précurseurs tels que le silane (SiH₄), l’ammoniac (NH₃), l’azote (N₂) et le protoxyde d’azote (N₂O)
Applications:
- Couches diélectriques : Diélectriques de grille, couches d’isolation, films pour condensateurs
- Revêtements de protection : Masques durs, couches de passivation, revêtements antireflets
- MEMS : Couches sacrificielles et matériaux structuraux pour systèmes microélectromécaniques
Conditions opératoires typiques
- Température du substrat : Température ambiante jusqu’à environ 400 °C
- Pression de procédé : Typiquement entre 600 et 1200 mTorr
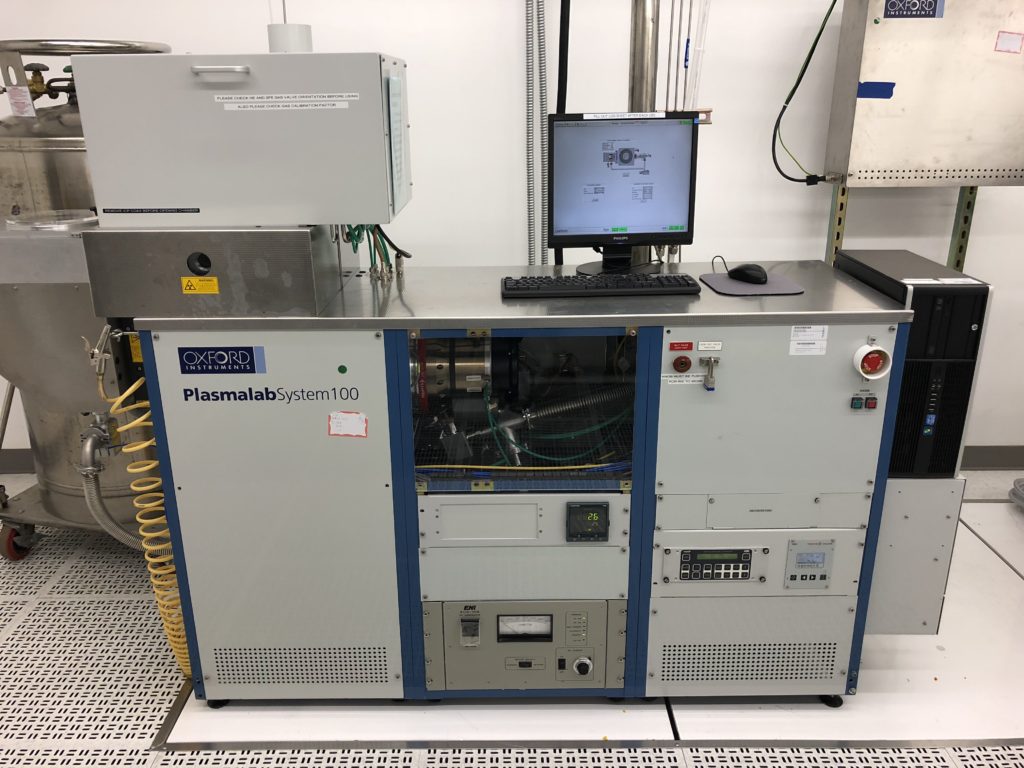

Équipement: Applied Materials Precision 5000 – PECVD (Dépôt chimique en phase vapeur assisté par plasma)
Description: Le système Applied Materials Precision 5000 (P5000) est une plateforme de traitement des semi-conducteurs de génération antérieure, généralement configurée comme un outil cluster multi-chambres permettant l’intégration de plusieurs procédés, dont le PECVD.
Les spécifications techniques varient selon la configuration spécifique, dépendant de l’utilisateur et de l’application. Le système est conçu pour exécuter des séquences de procédés complexes dans un environnement sous vide continu, améliorant l’efficacité, la reproductibilité et la flexibilité.
Caractéristiques:
- Architecture multi-chambres : Plateforme automatisée permettant d’effectuer différentes étapes de procédé (ex. dépôt, gravure, retrait) sur un même wafer sans rupture de vide, augmentant l’efficacité et la qualité des interfaces
- Polyvalence des procédés : Système hautement configurable, compatible avec plusieurs techniques de dépôt et de traitement, incluant :
-
- Dépôt chimique en phase vapeur (CVD / PECVD)
- Dépôt physique en phase vapeur (PVD)
- Dépôt par couches atomiques (ALD)Utilisé notamment pour le dépôt de tungstène et la fabrication intégrée de vias ou plugs en tungstène
- Contrôle de précision: Équipé de capteurs avancés (contrôleurs de débit massique, capteurs de pression, sondes de température) et d’un système de contrôle informatisé permettant un pilotage précis des paramètres de procédé (température, débit de gaz, pression)
- Compatibilité substrats: Compatible avec différents matériaux (silicium, verre, quartz), généralement jusqu’à 6 ou 8 pouces selon la configuration



Leave a Reply