
Équipement: Aligneur de masques SUSS MicroTec MA/BA6 Gen4
Description: Le SUSS MicroTec MA/BA6 Gen4 est un aligneur de masques en contact permettant l’alignement de motifs sur la face avant ou arrière d’un substrat, avec une résolution pouvant atteindre 1 µm. Le système offre plusieurs modes d’exposition avec une précision d’alignement (overlay) inférieure à 500 nm. Il est compatible avec des substrats allant de wafers de 150 mm de diamètre à de petits échantillons.
Caractéristiques:
- Alignement haute précision: Capacités d’alignement face avant (TSA) et face arrière (BSA) avec une excellente précision d’overlay
- Précision:
- Alignement face avant: ~500 nm (jusqu’à 250 nm avec la technologie optionnelle DirectAlign®)
- Alignement face arrière: généralement < 1 µm
- Microscopie: Microscope à champ divisé haute résolution avec caméras CCD et affichage numérique pour une détection précise des marques d’alignement, même en conditions de faible contraste
- Modes d’exposition polyvalents:
- Proximité
- Contact doux
- Contact dur
- Contact sous vide
- Résolution: Inférieure à 1 µm en mode contact sous vide, selon l’optique et la résine utilisées
- Optique: Technologie MO Exposure Optics® de SUSS utilisant des plaques à microlentilles pour une uniformité lumineuse supérieure, une meilleure stabilité du procédé et une réduction des effets de diffraction
- Manipulation des substrats:
- Compatible avec des tailles allant de 5 mm × 5 mm jusqu’à 150 mm (6 pouces)
- Traitement fiable de divers matériaux : silicium, verre, semi-conducteurs composés (GaAs, InP)
- Correction d’erreur de planéité: Système de compensation d’erreur de coin (WEC) assurant le parallélisme entre le masque et le substrat durant l’alignement et l’exposition
- Modularité et évolutivité: Conception modulaire permettant des mises à niveau et des fonctionnalités supplémentaires, telles que :
- Alignement pour collage de wafers (bond alignment) pour l’intégration 3D
- Lithographie par nanoimpression (UV-NIL, SMILE, SCIL) pour des résolutions inférieures à 50 nm
Applications:
- Lithographie optique de haute précision
- Alignement double face pour MEMS
- Intégration 3D et collage de wafers
- Photonique et microélectronique avancée
- Lithographie par nanoimpression
Équipement: Aligneur de masques EVG620
Description: Le système EVG620 est un aligneur de masques polyvalent et fiable, semi-automatique ou entièrement automatisé, utilisé pour la lithographie optique en face avant et double face. Il est principalement destiné aux environnements de micro- et nanofabrication, en R&D comme en production. Il est compatible avec des wafers et substrats jusqu’à 150 mm (6 pouces).
Caractéristiques:
- Capacités d’alignement: Alignement de haute précision en face avant et face arrière (lithographie double face)
- Précision:
- Alignement face avant: typiquement ±1,0 µm
- Alignement face arrière: jusqu’à ±1,25 µm (encore amélioré sur certaines configurations avancées)
- Modes d’alignement: Prise en charge de différents modes tels que overlay, réticule (crosshair) et mode transparent, avec microscopes à champ divisé haute résolution et caméras CCD
- Modes d’exposition:
- Contact sous vide: résolution ≤ 0,8 µm
- Contact dur: résolution ≤ 1,5 µm
- Contact doux: résolution ≤ 2,0 µm
- Proximité: exposition sans contact avec un entrefer réglable (1–1000 µm), résolution ≥ 2,5 à 3,0 µm
- Manipulation des substrats:
- Tailles: de petits échantillons jusqu’à 150 mm (6 pouces), avec options pour 200 mm
- Matériaux: compatible avec des matériaux fins, fragiles ou déformés, notamment les semi-conducteurs composés (InP, GaAs)
- Automatisation: Disponible en configurations manuelle, semi-automatique ou entièrement automatisée, avec systèmes de transfert cassette-à-cassette
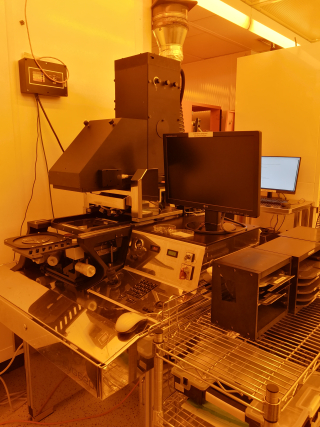

Équipement: SUSS MicroTec MA/BA6 Gen4 SMILE – Lithographie par nanoimpression (NIL)
Description: Le SUSS MicroTec MA/BA6 Gen4 est une plateforme semi-automatisée d’alignement de masques et de collage pouvant être équipée de la technologie SMILE (SUSS MicroTec Imprint Lithography Equipment) pour la lithographie par nanoimpression (NIL). Il est principalement destiné à la recherche et à la production en petits volumes dans des domaines tels que les MEMS, NEMS, l’intégration 3D et l’optique.
La technologie SMILE offre une méthode économique et très précise pour répliquer des micro- et nanopatterns via un procédé d’empreinte mécanique suivi d’un durcissement UV. Elle constitue une alternative à la photolithographie traditionnelle pour certaines applications.
Étapes clés du procédé:
Le procédé est conçu pour garantir des empreintes sans défaut, notamment en évitant l’encapsulation de bulles d’air dans les nanostructures :
- Dépôt de la résine : Une résine polymère photosensible durcissable aux UV est déposée sur le substrat (ex. wafer de silicium)
- Impression et étalement : Un moule flexible est mis en contact avec le substrat. Pour les nanostructures, le contact débute au centre puis se propage radialement (« onde de contact »), permettant une répartition homogène de la résine et le remplissage des cavités du moule. Le système de compensation active des défauts de parallélisme (WEC) assure un alignement précis et un contrôle de l’épaisseur résiduelle
- Polymérisation : La résine est durcie à l’aide d’une source UV intégrée, souvent à base de LED à haute efficacité énergétique, tout en maintenant le contact entre le moule et le substrat
- Séparation : Après durcissement, le moule et le substrat sont séparés automatiquement, laissant une réplique négative du motif dans la résine
Caractéristiques:
- Résolution : Résolution submicrométrique, avec alignement standard jusqu’à 1 µm et capacités de nanoimpression avancées
- Compatibilité des substrats : Prise en charge de substrats jusqu’à 150 mm (6 pouces), incluant silicium, verre et échantillons de différentes tailles
- Polyvalence : Conception modulaire permettant de basculer rapidement entre l’alignement de masques, l’alignement pour collage et les procédés SMILE de nanoimpression
- Précision d’alignement : Plateforme d’alignement haute précision avec capacités d’alignement face avant et face arrière pour un enregistrement couche-à-couche précis
- Évolutivité : Les procédés développés sur cette plateforme R&D peuvent être transférés vers des systèmes automatisés de production à haut volume de SUSS MicroTec
Applications:
La technologie SMILE est particulièrement adaptée à la fabrication de structures 3D et de composants optiques, notamment :
- Éléments optiques diffractifs (DOE) pour la réalité augmentée
- Caméras au niveau wafer (micro-lentilles)
- Dispositifs MEMS (systèmes microélectromécaniques)
- Composants photoniques et optoélectroniques
Équipement: TESCAN MIRA3 XMH – Lithographie par faisceau d’électrons (EBL)
Description: Le TESCAN MIRA3 XMH est un microscope électronique à balayage à émission de champ (FE-SEM) modulaire et haute performance, conçu pour la recherche avancée sur les matériaux, l’analyse multimodale et l’imagerie d’échantillons complexes. Équipé d’une source FEG Schottky, d’un mode de décélération du faisceau à basse énergie en option et d’une large gamme de détecteurs (SE, BSE, EBSD, EDS, WDS, STEM, CL), il offre à la fois une haute résolution et une grande flexibilité.
Sa chambre de grande capacité permet l’intégration de multiples détecteurs et le traitement d’échantillons de grande taille, ce qui en fait un outil idéal pour la recherche, l’analyse de défaillance et la caractérisation avancée des matériaux. Le système est également configuré pour la lithographie par faisceau d’électrons (EBL), permettant la fabrication directe de motifs à l’échelle nanométrique.
Caractéristiques:
- Source d’électrons : Canon à émission de champ Schottky (FEG) à haute brillance, offrant une imagerie à haute résolution, à fort courant et à faible bruit
- Résolution : Résolution typique d’environ 2 nm en lithographie EBL, permettant la réalisation de motifs de quelques dizaines de nanomètres, voire inférieurs à 50 nm selon la résine et les conditions de procédé
- Système EBL : Équipé d’un blanker électrostatique et du logiciel propriétaire TESCAN DrawBeam pour la génération de motifs précis sur des surfaces recouvertes de résine
- Plateau et zone d’écriture : Chambre extra-large (XMH) avec plateau à interférométrie laser (LIS) de haute précision, permettant une écriture répétable sur de grandes surfaces (jusqu’à environ 45 mm × 45 mm)
- Tension d’accélération : Plage de fonctionnement de 200 V à 30 kV, offrant une grande flexibilité pour l’imagerie et la lithographie
- Technologies intégrées :
- Wide Field Optics™ pour une navigation simplifiée
- In-Flight Beam Tracing™ pour l’optimisation en temps réel du faisceau
Applications:
Le MIRA3 XMH avec capacité EBL est principalement utilisé en nanofabrication et en recherche pour la lithographie directe par faisceau d’électrons, permettant la création de structures extrêmement fines à l’échelle nanométrique dans des domaines tels que :
- Recherche en semi-conducteurs
- Science des matériaux
- Nanotechnologies
- Bio-ingénierie


Équipement: Raith E-Line – Lithographie par faisceau d’électrons (EBL)
Description: Le Raith E-Line est un système de lithographie par faisceau d’électrons (EBL) haute performance et polyvalent, conçu pour la nanofabrication avancée, la recherche et le prototypage. Il est souvent décrit comme une plateforme « tout-en-un » combinant imagerie SEM, mesure et écriture nanométrique dans un seul outil.
Le système intègre une colonne de microscope électronique à balayage (souvent ZEISS Gemini), un plateau de positionnement de haute précision contrôlé par interférométrie laser, ainsi qu’un logiciel avancé pour la génération et l’exécution des motifs.
Caractéristiques:
- Haute résolution : Capable de réaliser des motifs avec des largeurs inférieures à 10 nm, avec un diamètre de faisceau pouvant descendre en dessous de 1,6 nm
- Imagerie SEM intégrée : Permet l’imagerie haute résolution, la métrologie et la lithographie EBL sans déplacer l’échantillon
- Plateforme à interférométrie laser :
- Résolution de positionnement de l’ordre de 1–2 nm
- Course de déplacement jusqu’à environ 100 mm × 100 mm (compatibilité jusqu’à wafers 4 pouces)
- Écriture sans erreurs de raccord (stitching-free) : Mode FBMS (Fixed Beam Moving Stage) / Traxx permettant de déplacer l’échantillon sous un faisceau fixe, éliminant les discontinuités dans les motifs longs (ex. guides d’ondes optiques)
- Logiciel avancé : Suite Raith Nanosuite assurant le flux complet de travail : conception CAD (GDSII), préparation des jobs, alignement, mise au point et exposition automatisée
- Options modulaires :
- Système d’injection de gaz (GIS) pour dépôt ou gravure assistée par faisceau (FEBID)
- Nanomanipulateurs pour sondage électrique in situ
- Tension d’accélération : Plage étendue d’environ 20 eV à 30 kV, permettant l’optimisation des conditions de faisceau selon les résines et applications
Applications:
Le Raith E-Line est largement utilisé en recherche académique et en prototypage industriel pour :
- Nanoélectronique et dispositifs semi-conducteurs
- Photonique et métamatériaux optiques
- Dispositifs quantiques
- Bio-ingénierie (structures et substrats précis)
- Science des matériaux (dépôt ou gravure assistée par faisceau)
Équipement: DWL PicoMaster 150 – Système de lithographie laser directe (Direct Writer)
Description: Le DWL PicoMaster 150 (également commercialisé sous les marques Raith PicoMaster 150 ou 4PICO Litho) est un système de lithographie laser directe haute résolution, conçu principalement pour la recherche et le prototypage rapide. Il permet de générer des motifs sans masque photolithographique, en utilisant un faisceau laser focalisé.
Ce système est particulièrement adapté aux environnements R&D nécessitant une grande flexibilité de conception et des cycles d’itération rapides, tout en offrant une résolution submicronique et des capacités avancées de structuration en niveaux de gris.
Caractéristiques:
- Résolution :
- Taille minimale des motifs jusqu’à ~300 nm avec une source laser 405 nm
- Jusqu’à ~270 nm avec une source optionnelle 375 nm
- Lithographie en niveaux de gris (grayscale) :
- Jusqu’à 4096 niveaux de gris
- Permet la fabrication de structures 2.5D et 3D complexes
- Idéal pour les éléments optiques diffractifs (DOE), micro-optiques et structures holographiques
- Sans masque (maskless / direct write) :
- Modification rapide des designs sans fabrication de masque
- Réduction significative des délais de prototypage
- Compatibilité des substrats :
- Substrats de petites pièces jusqu’à environ 160 mm × 160 mm (6” × 6”)
- Compatible avec wafers et masques
- Autofocus intégré :
- Système d’autofocus en temps réel basé sur laser
- Compensation des variations de topographie pour maintenir une qualité d’exposition constante
- Logiciel intégré :
- PicoMaster Project Manager
- Support des formats GDSII, DXF, CIF pour l’import de designs
- Conception compacte :
- Système autonome intégrant contrôle, optique et pompage
- Adapté aux salles blanches avec contraintes d’espace
Applications:
Le DWL PicoMaster 150 est largement utilisé en microfabrication et nanotechnologies pour :
- Micro-optiques (réseaux de microlentilles, lentilles de Fresnel)
- Photonique
- MEMS
- Microfluidique
- Structures holographiques et sécurité optique
- Recherche en semi-conducteurs et fabrication de masques




Leave a Reply