Équipement: KLA Tencor Stylus Profiler P-7
Description: Le KLA Tencor P-7 Stylus Profiler est un système de métrologie de niveau recherche et production utilisé pour la caractérisation de la topographie de surface en 2D et 3D. Il fonctionne selon une méthode de contact mécanique à l’aide d’une pointe diamantée (stylus) qui balaie la surface de l’échantillon. Il est largement utilisé dans les domaines des semi-conducteurs et de la micro/nanofabrication.
Caractéristiques:
- Capacités de mesure :
- Hauteurs de marche (step height) de l’échelle nanométrique jusqu’à ~1 mm
- Rugosité et ondulation de surface
- Courbure et forme du substrat (wafer bow)
- Contraintes de films minces (via l’équation de Stoney)
- Haute résolution :
- Résolution verticale pouvant atteindre l’échelle sub-nanométrique (jusqu’à ~0,0078 Å selon configuration)
- Résolution horizontale jusqu’à ~25 nm
- Longueurs de balayage :
- Scans continus jusqu’à 150 mm sans assemblage (stitching), garantissant l’intégrité des mesures sur de grands substrats
- Contrôle de force constant :
- Système UltraLite avec contrôle dynamique de la force appliquée (de ~0,03 mg à 50 mg)
- Permet de mesurer des matériaux fragiles (ex. résine photo) sans les endommager
- Automatisation :
- Alignement automatique par reconnaissance de motifs
- Séquences de recettes automatisées
- Communication SECS/GEM pour intégration en environnement industriel
- Logiciel :
- Interface intuitive avec suite Apex pour analyse avancée des données, filtrage, et génération de rapports conformes aux normes ISO et ASME
Applications:
Le KLA Tencor P-7 est utilisé en R&D et en production pour :
- Mesure des taux de gravure et de dépôt (etch, sputtering, CMP)
- Profilage de tranchées gravées et de cratères SIMS
- Analyse de défauts de surface (rayures, irrégularités)
- Mesure du bow et de la planéité des wafers
- Caractérisation de la texture de surface dans divers domaines (semi-conducteurs, biomédical, électronique grand public)


Équipement: Bruker Dektak XT – Profilomètre à stylet
Description: Le Bruker Dektak XT est un profilomètre de surface haute performance utilisé pour la métrologie de topographie en micro- et nanofabrication. Il permet de mesurer de manière répétable et précise des paramètres tels que les hauteurs de marche, la rugosité et l’ondulation de surface. Le système repose sur un stylet diamanté qui balaye physiquement la surface de l’échantillon, avec détection des variations verticales via un capteur LVDT.
Son architecture mécanique en arche unique (single-arch) améliore la rigidité du système et réduit les perturbations environnementales, permettant des mesures stables avec une précision à l’échelle angström.
Caractéristiques:
- Principe de mesure :
- Stylet diamanté en contact avec la surface
- Détection des déplacements verticaux via capteur LVDT (Linear Variable Differential Transformer)
- Haute répétabilité :
- Répétabilité des hauteurs de marche de l’ordre de quelques angströms (≈ 4 Å pour une marche de 1 µm, selon conditions)
- Plage et résolution :
- Plage verticale jusqu’à ~1 mm
- Résolution verticale pouvant atteindre ~0,1 nm selon la configuration
- Force du stylet ajustable :
- De ~0,03 mg (capteur basse force N-Lite+) jusqu’à ~15 mg
- Permet la mesure de surfaces fragiles sans endommagement
- Capacités de scan :
- Scans 2D jusqu’à ~55 mm en continu
- Cartographie 3D possible sur wafers jusqu’à 200 mm via stitching
- Logiciel et automatisation :
- Logiciel Vision64 (64-bit) avec interface intuitive
- Mesures multi-sites automatisées, reconnaissance de motifs et analyse avancée des données
- Génération de rapports personnalisés
Applications:
Le Dektak XT est largement utilisé pour :
- Mesure d’épaisseur de couches minces et épaisses
- Caractérisation de la rugosité et de la texture de surface
- Analyse de contraintes dans les films minces (via la courbure du substrat)
- Profilage de structures MEMS et microfluidiques (hauteurs importantes jusqu’à ~1 mm)
- Contrôle qualité en microfabrication et production industrielle
- Analyse dimensionnelle de motifs conducteurs (ex. photovoltaïque)
Équipement: Microscope optique Olympus MX51
Description: Le Olympus MX51 est un microscope optique industriel robuste conçu pour l’inspection en lumière réfléchie des composants électroniques, métaux, plastiques et wafers. Il est largement utilisé en environnement industriel et en recherche pour l’analyse visuelle, le contrôle qualité et l’inspection de surfaces. Grâce à son système optique UIS (Universal Infinity System) et sa conception modulaire, il offre une imagerie de haute qualité avec une grande flexibilité d’utilisation.
Caractéristiques:
- Polyvalence d’application :
- Inspection de semi-conducteurs
- Analyse de moules et matériaux
- Inspection de circuits imprimés (PCB)
- Caractérisation générale en science des matériaux
- Modes d’éclairage :
- Champ clair (Brightfield) pour l’imagerie standard
- Champ sombre (Darkfield) pour accentuer les défauts de surface et les contrastes
- Selon configuration (MX51-F) : contraste de phase et fluorescence
- Optique :
- Système UIS (Universal Infinity System) d’Olympus
- Images nettes avec correction des aberrations et excellente qualité optique
- Ergonomie :
- Tête d’observation confortable
- Commandes frontales intuitives (Frontal Control) pour une utilisation efficace en routine
- Modularité :
- Plateforme flexible permettant l’ajout de caméras, objectifs et accessoires selon les besoins spécifiques
- Adapté à une utilisation en inspection manuelle ou assistée par caméra
Applications:
- Inspection visuelle de wafers et dispositifs microfabriqués
- Contrôle qualité en fabrication électronique
- An
- alyse de défauts de surface (rayures, particules, contamination)
- Observation de structures micro- et millimétriques
- Support aux procédés de lithographie et de fabrication MEMS

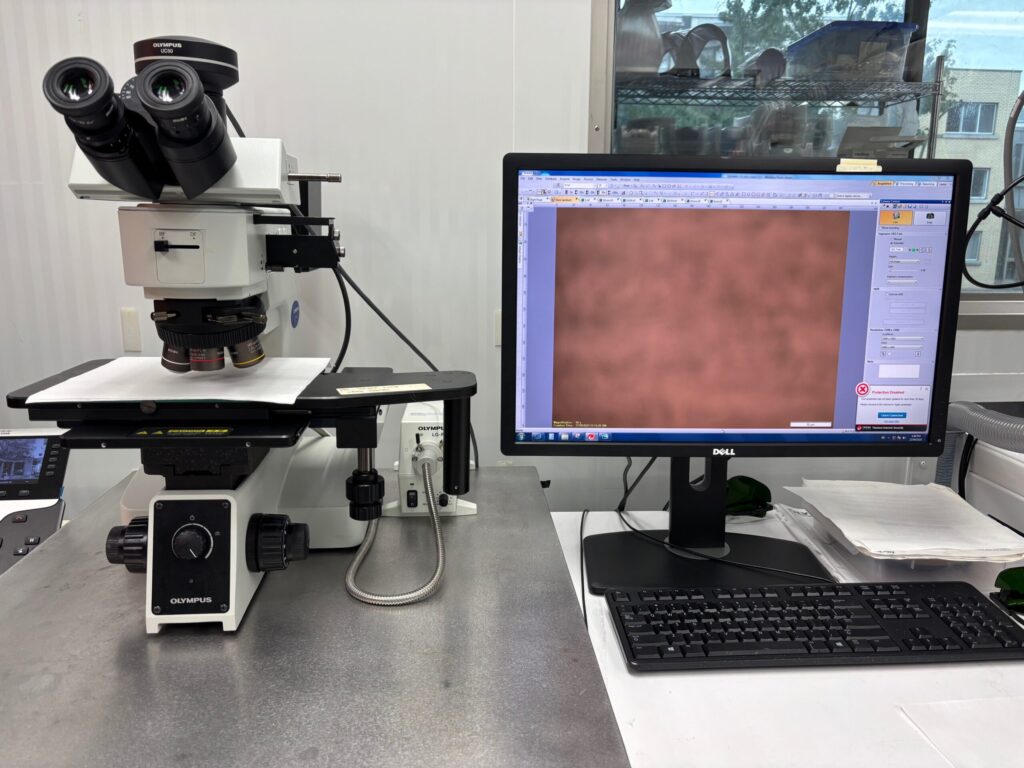

Équipement: Nanometrics NanoSpec – Réflectomètre optique (spectroscopie de réflectance)
Description: Le Nanometrics NanoSpec Reflectometer est un outil de métrologie optique sans contact largement utilisé en micro- et nanofabrication pour mesurer l’épaisseur de couches minces transparentes ou semi-transparentes déposées sur des substrats réfléchissants, typiquement des wafers en silicium. Il est basé sur le principe de la spectroscopie de réflectance et des interférences lumineuses.
Principe de fonctionnement:
- Une source lumineuse (lampe halogène ou deutérium) émet un faisceau couvrant une plage de longueurs d’onde (typiquement visible : ~370 nm à 800 nm).
- La lumière est dirigée vers la surface du film.
- Une partie de la lumière est réfléchie à la surface supérieure du film, tandis qu’une autre est réfléchie à l’interface film/substrat.
- L’interférence entre ces deux signaux crée une signature spectrale caractéristique (variation sinusoidale de l’intensité en fonction de la longueur d’onde).
- Un spectromètre mesure cette intensité réfléchie sur l’ensemble du spectre.
- Le logiciel utilise des modèles optiques (indices de réfraction, coefficients de Cauchy, etc.) pour extraire l’épaisseur du film et, dans certains cas, son indice de réfraction.
Caractéristiques:
- Mesure sans contact : Méthode optique non destructive, sans risque d’endommager l’échantillon
- Large plage d’épaisseur :
- Typiquement de < 10 nm (~100 Å) jusqu’à plusieurs dizaines de microns (≈ 50 µm ou plus selon configuration)
- Petite taille de spot :
- Objectifs interchangeables (5×, 10×, 50×)
- Taille de mesure pouvant descendre jusqu’à ~5 µm, permettant les mesures sur structures localisées (pads, motifs)
- Automatisation :
- Systèmes AFT (Automated Film Thickness) pour mesures rapides et reproductibles
- Cartographie d’uniformité sur wafer possible
- Compatibilité matériaux :
- Programmes préconfigurés pour matériaux courants : SiO₂, Si₃N₄, photoresist, polysilicium sur silicium
Applications :
Le NanoSpec est utilisé principalement pour le contrôle et le suivi des procédés en microfabrication :
- Mesure d’épaisseur des couches déposées ou gravées
- Caractérisation de l’épaisseur de résine photo lors de la lithographie
- Contrôle de l’uniformité des films sur wafer
- Mesure des couches diélectriques dans les dispositifs microélectroniques
Équipement: NanoCalc Reflectometer – Spectroscopie de réflectance optique
Description: Le NanoCalc reflectometer est un système de spectroscopie de réflectance utilisé pour la mesure rapide et non destructive de l’épaisseur de couches minces ainsi que de leurs propriétés optiques (indice de réfraction n et coefficient d’absorption k). Développé par des fabricants tels que Ocean Insight (anciennement Ocean Optics) et Mikropack (aujourd’hui KaPaTek), il est largement utilisé en microélectronique, optique et science des matériaux.
Principe de fonctionnement:
- Le système envoie un faisceau lumineux (UV, visible, proche infrarouge) vers l’échantillon à incidence normale (~90°).
- La lumière est réfléchie par les interfaces du film (surface supérieure et interface film/substrat).
- Les interférences entre les faisceaux réfléchis génèrent un signal spectral caractéristique dépendant de l’épaisseur et des propriétés optiques du film.
- Un spectromètre analyse l’intensité réfléchie sur une plage de longueurs d’onde.
- Des modèles optiques et bases de données de matériaux permettent d’extraire l’épaisseur et, dans certains cas, les paramètres n et k.
Caractéristiques:
- Mesure sans contact : Technique optique non destructive, sans préparation spécifique de l’échantillon
- Plage de mesure :
- Épaisseurs typiquement de ~1 nm jusqu’à plusieurs centaines de micromètres (~250 µm ou plus selon configuration)
- Haute résolution :
- Résolution typique de l’ordre de ~0,1 nm
- Polyvalence des matériaux :
- Films transparents ou semi-transparents : SiO₂, SiNₓ, résines photo, polymères
- Compatible avec substrats et certaines couches métalliques ou rugueuses selon le modèle
- Capacités logicielles :
- Analyse de structures multicouches (jusqu’à ~10 couches selon version)
- Bibliothèques intégrées de constantes optiques (n et k)
- Simulation et ajustement des modèles de film
- Options d’automatisation :
- Objectifs micro-spot pour zones très localisées
- Plateformes de cartographie XY pour mapping 2D/3D sur wafers jusqu’à 300 mm
Applications :
- Fabrication de semi-conducteurs : mesure de photoresist, oxydes, nitrures
- Revêtements optiques : traitements antireflet, anti-rayures, couches fonctionnelles
- Recherche et développement : MEMS, microfluidique, photovoltaïque
- Contrôle de procédé : suivi en ligne (in-situ) de l’épaisseur et des taux de gravure/polissage
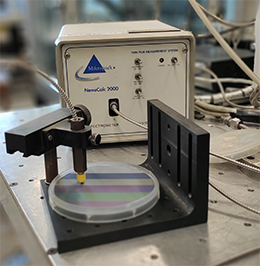

Équipement: Quanta FEG 450 – Microscope électronique à balayage (SEM / ESEM)
Description: Le Quanta FEG 450 est un microscope électronique à balayage avancé de type environnemental (ESEM) utilisant une source à émission de champ (Field Emission Gun, FEG). Il est conçu pour l’imagerie haute résolution et la caractérisation de matériaux variés, y compris des échantillons non conducteurs, hydratés ou sensibles, avec une préparation minimale.
Modes de fonctionnement:
- High Vacuum (HV) : Mode SEM classique pour échantillons conducteurs ou recouverts d’un film conducteur (or, carbone, etc.). Permet une résolution maximale.
- Low Vacuum (LV) : Permet d’imager des échantillons non conducteurs sans métallisation grâce à une pression partielle de gaz qui neutralise les charges.
- Environmental SEM (ESEM) : Permet l’observation d’échantillons humides, biologiques ou volatils dans leur état naturel en maintenant une atmosphère contrôlée (vapeur d’eau), sans déshydratation préalable
Caractéristiques principales:
- Source FEG (Field Emission Gun) : Faisceau d’électrons à haute brillance et cohérence, permettant une excellente résolution spatiale.
- Haute résolution : Jusqu’à ~1 nm à 30 kV (selon conditions d’imagerie et type d’échantillon).
- Détecteurs multiples :
- Détecteur d’électrons secondaires (SE) → topographie de surface
- Détecteur d’électrons rétrodiffusés (BSE) → contraste compositionnel (Z-contrast)
- Options analytiques :
- EDS (Energy Dispersive Spectroscopy) → analyse élémentaire
- EBSD (Electron Backscatter Diffraction) → orientation cristallographique
- Stage motorisé & interface utilisateur : Navigation précise sur de grandes surfaces avec une interface intuitive de type “point-and-click”.
- Polyvalence des échantillons : Compatible avec métaux, polymères, composites, semi-conducteurs, échantillons biologiques, géologiques et nanostructures.
Applications :
- Caractérisation de surfaces et morphologie à l’échelle micro/nano
- Analyse de défauts (cracks, particules, contamination)
- Inspection de dispositifs microélectroniques et MEMS
- Analyse de composition (EDS) et structure cristalline (EBSD)
- Observation d’échantillons sensibles à l’environnement (ESEM)
Équipement: Everbeing – Station de mesure 4 pointes (4-probe / Kelvin probe station)
Description: Les stations de test 4 pointes proposées par Everbeing International Corp. sont des systèmes de métrologie électrique utilisés pour mesurer la résistivité, la conductivité et la résistance en nappe (sheet resistance) de films minces, wafers et matériaux semi-conducteurs. Elles reposent sur la méthode Kelvin à quatre pointes, qui permet d’éliminer les effets de résistance des câbles et des contacts.
Principe de mesure:
- Quatre pointes alignées (souvent en tungstène) sont mises en contact avec la surface de l’échantillon.
- Deux pointes externes injectent un courant.
- Deux pointes internes mesurent la tension.
- La configuration Kelvin permet de calculer la résistivité sans être affectée par les résistances de contact ou des fils.
Caractéristiques principales:
- Mesures électriques précises :
- Résistance en nappe (sheet resistance)
- Résistivité volumique
- Conductivité
- Typage P/N (dans certains cas)
- Caractérisation I–V (courant-tension)
- Pointes de contact :
- Pointes en carbure de tungstène
- Montage à ressort pour une force constante
- Espacement fixe pour reproductibilité des mesures
- Intégration avec instruments externes :
- Utilisation avec SMU (Source Measure Unit) ou combinaison source de courant + voltmètre
- Chuck (support échantillon) :
- Différentes options : acier inoxydable, plaqué or, téflon
- Tailles typiques : 2″ à 12″ wafers
- Options : chuck sous vide et chauffant pour mesures à température contrôlée
- Microscopie intégrée :
- Microscope monozoom ou trinoculaire
- Grossissement jusqu’à ~1650× pour un positionnement précis des pointes
- Micropositionneurs :
- Déplacement X-Y-Z haute précision (jusqu’à ~0,3 µm)
- Bases magnétiques ou à vide pour stabilité mécanique
- Connectivité :
- Interfaces variées : BNC, triaxial, bananes 4 mm
- Optimisées pour mesures à faible fuite (low leakage)
Applications :
- Caractérisation de films minces conducteurs ou semi-conducteurs
- Mesure de résistivité de wafers (Si, GaN, métaux, etc.)
- Contrôle qualité en microfabrication
- Évaluation de procédés (dopage, dépôt, métallisation)
- Recherche et développement en électronique et matériaux
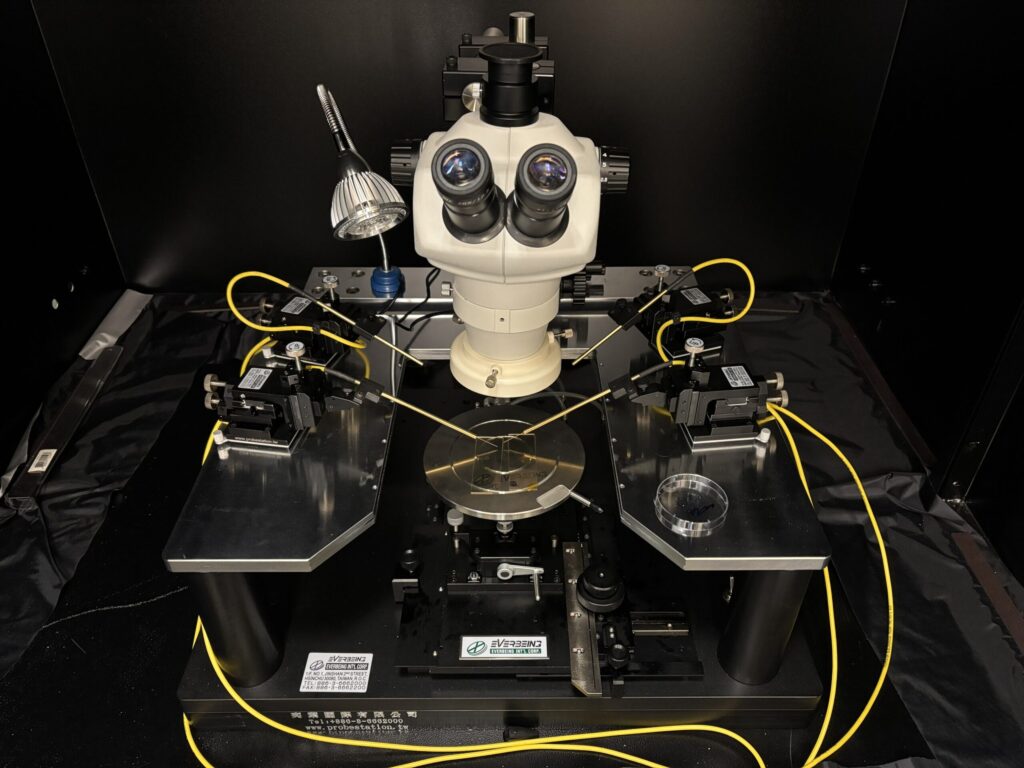



Leave a Reply