
Tool: Suss MicroTec MA/BA6 Gen4 Mask Aligner
Description: The SUSS MicroTec MA/BA6 contact aligner allows users to align patterns on the front or back of a substrate and to print feature sizes down to 1 µm. The tool offers a variety of exposure methods with overlay accuracy better than 500 nm. It can accommodate substrates ranging from 150 mm diameter wafers down to small pieces.
Key features:
- High Precision Alignment: The system offers both top-side (TSA) and bottom-side (BSA) alignment capabilities, achieving excellent overlay accuracy.
- Accuracy: Top-side alignment accuracy is typically around 500 nm (0.5 µm), with the optional DirectAlign® technology capable of reaching down to 250 nm (0.25 µm). Bottom-side alignment accuracy is generally less than 1 µm.
- Microscopy: It uses high-resolution split-field microscopes with CCD cameras and digital displays for easy and precise alignment mark detection, even under poor contrast conditions.
- Versatile Exposure Modes: The aligner supports a variety of exposure methods to accommodate different process requirements and resist thicknesses.
- Modes: Proximity, Soft Contact, Hard Contact, and Vacuum Contact exposure modes are available.
- Resolution: Achievable resolution can be below 1 µm in vacuum contact mode, depending on the specific optics and resist used.
- Optics: Features SUSS’s unique MO Exposure Optics® which use micro-lens plates for superior light uniformity and process stability, reducing diffraction effects and enabling source-mask optimization.
- Substrate Handling: The system is designed for flexibility in handling various substrate types and sizes.
- Wafer Sizes: Accommodates wafers and pieces from 5 mm x 5 mm up to 150 mm (6 inches).
- Material Compatibility: Can reliably process a wide range of materials, including silicon, glass, and compound semiconductors (e.g., GaAs, InP).
- Wedge Error Correction: Includes Wedge Error Compensation (WEC) to ensure the mask and substrate remain parallel during alignment and exposure.
- Modular and Upgradeable: The MA/BA6 Gen4 has a modular design that allows for field upgrades and added functionality, such as:
- Bond Alignment: Used for precise wafer-to-wafer alignment, which is critical for 3D integration and subsequent wafer bonding processes.
- Imprint Lithography: Supports various micro- and nanoimprint lithography (UV-NIL, SMILE, SCIL) solutions for sub-50 nm resolution patterning.
The MA/BA6 Gen4 is designed to offer a bridge between academic research and industrial production environments, with an intuitive Windows-based user interface and a compact footprint.
Description: The EVG 620 is a versatile and reliable semi-automated or automated mask alignment system used for optical top-side and double-sided lithography, primarily in micro- and nanofabrication for R&D and production environments. It accommodates wafers and substrates up to 150 mm (6 inches).
Key features:
- Alignment Capabilities: The system is known for its high precision, offering top-side and bottom-side alignment (double-sided lithography).
- Accuracy: Top-side alignment accuracy is typically around ±1.0 µm, while bottom-side alignment can achieve ±1.25 µm (even finer with NT models and R&D setups).
- Modes: It supports various alignment modes including overlay, crosshair, and transparent modes, often utilizing high-resolution split-field microscopes with CCD cameras.
- Exposure Modes: The EVG 620 can operate in several exposure modes to achieve different resolutions and results:
- Vacuum Contact: Achieves the highest resolution (≤ 0.8 µm).
- Hard Contact: Resolution of ≤ 1.5 µm.
- Soft Contact: Resolution of ≤ 2.0 µm.
- Proximity: Offers contact-free exposure with an adjustable gap (1–1000 µm) for resolutions of ≥ 2.5 µm to 3.0 µm.
- Substrate Handling:
- Size: Handles wafer and substrate sizes from small pieces up to 150 mm (6 inches), with options for 200 mm.
- Material: Safely processes thin, fragile, or warped materials like compound semiconductors (e.g., InP, GaAs).
- Automation: Available in manual, semi-automated, or fully automated configurations with cassette-to-cassette handling systems.
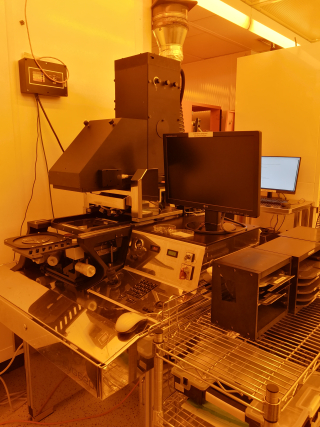

Tool: Suss MicroTec MA/BA6 Gen4 SMILE, nanoimprint lithography
Description: The SUSS MicroTec MA/BA6 Gen4 is a semi-automated mask and bond aligner platform that can be optionally equipped with the SMILE (SUSS MicroTec Imprint Lithography Equipment) technology for nanoimprint lithography (NIL). It is designed primarily for research and low-volume production in applications such as MEMS, NEMS, 3D integration, and optics.SMILE technology provides a cost-effective and highly precise method to replicate both micro- and nanopatterns using a mechanical imprinting process followed by UV curing. This technique is an alternative to traditional photolithography for specific applications
Key Process Steps
The process ensures defect-free imprints by avoiding air bubble encapsulation, especially for nanostructures.
- Resist Application: A photosensitive, UV-curable polymer resist is dispensed onto the substrate (e.g., a silicon wafer).
- Imprinting & Spreading: A flexible stamp is brought into contact with the substrate. For nanostructures, contact begins in the center and a “contact wave” extends radially outward, spreading the resist and filling the stamp’s cavities with the material. The system’s active wedge error compensation ensures parallel alignment and controlled residual layer thickness.
- Curing: The resist is then solidified using an integrated UV light source, often an energy-efficient LED source, while the stamp and substrate remain in contact.
- Separation: After curing, the stamp and substrate are separated automatically, leaving a negative replica of the stamp’s pattern in the resist on the substrate.
Key Features of the MA/BA6 Gen4 Platform with SMILE
- Resolution: Capable of submicron resolution, with standard mask alignment resolution down to 1 µm, and deep nanoimprint capabilities.
- Substrate Compatibility: Accommodates various substrates up to 150 mm (6 inches) in diameter, including silicon, glass, and pieces of different sizes.
- Versatility: The modular design allows the system to switch quickly between standard mask alignment, bond alignment, and SMILE imprint processes, making it highly flexible for research environments.
- Alignment Precision: The tool features a high-precision alignment stage with capabilities for topside and backside alignment, ensuring accurate layer-to-layer registration.
- Scalability: Processes developed on this R&D platform can be easily transferred to SUSS MicroTec’s automated high-volume production platforms.
Applications
- SMILE technology is particularly suited for fabricating 3D structures and optical components.
- Diffractive Optical Elements (DOEs) for augmented reality applications
- Wafer-level cameras (micro-lenses)
- MEMS (Microelectromechanical Systems) devices
- Photonics and optoelectronics components
Description: The TESCAN MIRA3 XMH is a high-performance modular Field Emission Scanning Electron Microscope (FE-SEM) designed for advanced materials research, multi-modal analysis, and challenging sample imaging. With its Schottky FEG source, optional low-energy beam deceleration, versatile detector integration (SE, BSE, EBSD, EDS, WDS, STEM, CL), and automation capabilities, the MIRA3 XMH provides both high resolution and flexibility. Its larger chamber variant supports mounting of larger samples and accommodates multiple detector ports, making it ideal for research, failure analysis, and next-generation materials characterization.
Key Features and Specifications
- Electron Source: It utilizes a high-brightness Schottky field emission gun (FEG) for high-resolution, high-current, and low-noise imaging.
- Resolution: The typical resolution for EBL patterning is around 2 nm, with a potential to create features in the tens of nanometers range or less than 50 nm using appropriate resists and configurations.
- Electron Beam Lithography (EBL) System: The system is specifically equipped with an electrostatic beam blanker and the proprietary TESCAN DrawBeam software for creating fine patterns on a resist-coated sample surface.
- Stage and Patterning Area: The XMH model includes an extra-large chamber and a highly precise laser-based interferometric (LIS) stage. This enables accurate and repeatable patterning over a large area, typically up to 45 mm x 45 mm, which is a key feature for EBL applications over conventional SEMs.
- Accelerating Voltage: The operating voltage ranges from 200 V to 30 kV, allowing for flexibility in imaging and lithography processes.
- Integrated Technologies: The system incorporates Wide Field Optics™ for easy navigation and In-Flight Beam Tracing™ for real-time beam optimization, simplifying operation.
Primary Application
The MIRA3 XMH with EBL capability is primarily used in nanofabrication and research environments to perform direct-write electron beam lithography. This allows researchers to define and create extremely small structures and devices in the nanometer range for applications in fields like semiconductor research, materials science, and bioengineering


Description: The Raith E-Line is a high-performance, versatile electron beam lithography (EBL) system designed for advanced nanofabrication, research, and prototyping, often referred to as the “Swiss Army knife of nanofabrication” due to its multifunctionality. The system includes a high-resolution scanning electron microscope (SEM) column, often a ZEISS Gemini column. It also has a precise, laser-interferometer-controlled stage and patterning software.
Key Features and Capabilities
- High Resolution: The E-Line can create extremely fine features, typically with line widths of less than 10 nm and beam sizes down to sub-1.6 nm.
- Integrated SEM Imaging: It functions as a complete nano-engineering workstation. It allows for high-resolution imaging, measurement, and EBL patterning within the same system without moving the sample.
- Laser Interferometer Stage: The system uses a precise stage with a resolution of 1-2 nm and a travel range of up to 100×100 mm (or 4-inch wafer capability). This enables accurate positioning and large-area patterning.
- Stitching-Error-Free Writing: A key feature is the proprietary Fixed Beam Moving Stage (FBMS) or Traxx mode. This moves the sample continuously under a fixed electron beam. This eliminates stitching errors when creating long, continuous patterns, such as optical waveguides.
- Flexible and Automated Software: The Raith Nanosuite software suite manages the workflow from CAD design (GDSII format support) and job preparation to automated exposure, focus, and alignment procedures.
- Versatile Options: The E-Line can be field-upgraded with options, including a gas injection system (GIS) for Focused Electron Beam-Induced Deposition (FEBID) or etching, and nanomanipulators for in-situ electrical probing.
- Variable Accelerating Voltage: The accelerating voltage can be varied from 20 eV to 30 kV. This provides flexibility to optimize beam conditions for different resists and applications.
Primary Applications
The Raith E-Line is widely used in academic research and industrial prototyping. It is used for applications including:
- Nanoelectronics and semiconductor research
- Photonics and optical metamaterials
- Quantum device fabrication
- Bioengineering research (e.g., creating precise scaffolds)
- Materials science, including direct-write deposition or etching of materials
Description: The DWL PicoMaster 150 (often branded as Raith PicoMaster 150 or a product by 4PICO Litho) is a standalone, high-resolution direct-write laser lithography system designed primarily for research and development (R&D) and rapid prototyping. It is known for its high precision and its capability to produce sub-micron features using a focused laser beam, without the need for a physical photomask.
Key Features and Specifications
- Resolution: The system can achieve a minimum feature size down to 300 nm with its standard 405 nm laser source, and potentially down to 270 nm with an optional 375 nm source. This allows for the creation of features often associated with e-beam quality optics.
- Grayscale Lithography: A major highlight is its powerful grayscale exposure mode, offering up to 4096 levels of grayscale. This enables the creation of complex 2.5D and 3D microstructures, such as micro-optics, diffractive optical elements (DOEs), and holographic security features, with excellent surface smoothness in thick photoresists.
- Maskless & Direct Write: The system operates without masks, allowing for instant design changes and faster iteration cycles, which is ideal for R&D environments.
- Substrate Versatility: It supports a wide range of substrate sizes, from small pieces (5×5 mm²) up to 6″x6″ (or 160×160 mm²) wafers or masks.
- Autofocus System: A real-time, laser-controlled autofocus system automatically corrects for height variations in the substrate surface, ensuring consistent focus and exposure quality even on challenging or non-flat materials.
- Integrated Design Software: The system includes the PicoMaster Project Manager software, which is user-friendly and supports common data formats like GDSII, DXF, and CIF.
- Compact Design: The PicoMaster 150 is a standalone unit with a compact footprint, enclosing all necessary components (including control rack and vacuum pump), making it suitable for cleanrooms with limited space.
Applications
The PicoMaster 150 is a versatile tool widely used across various fields of nanotechnology and microfabrication:
- Micro-optics (e.g., microlens arrays, Fresnel lenses)
- Photonics
- MEMS (Micro-Electro-Mechanical Systems)
- Microfluidics
- Security and Holographics (e.g., optical security features)
- Semiconductor Research and general mask making
The system serves as a bridge technology, offering a balance between the high resolution of e-beam lithography and the speed/throughput of traditional optical lithography systems.



Leave a Reply