Description: KLA Tencor P-7 Stylus Profiler is a research and production-grade metrology system used for measuring surface topography in 2D and 3D. It uses a mechanical contact method with a diamond-tipped stylus to measure various parameters across a sample surface, primarily in semiconductor and nanofabrication applications.
Features:
- Measurement Capabilities: The P-7 can measure a wide range of surface characteristics, including step heights from nanometers to 1 mm, surface roughness and waviness, sample bow and shape, and thin film stress (using Stoney’s equation).
- High Resolution: The system offers a high vertical resolution, with some configurations reaching as low as 0.0078 Å (sub-nanometer), and a maximum horizontal resolution of 25 nm.
- Long Scan Lengths: It can perform scans up to 150 mm without needing to stitch individual scans together, which ensures measurement integrity across large samples.
- Constant Force Control: The UltraLite sensor assembly features dynamic, constant force control, adjustable from 0.03 mg to 50 mg. This feature allows for accurate measurements on both hard and soft materials, such as photoresist, without causing damage.
- Automation: The system can be configured for full automation with features like pattern recognition for automatic sample alignment, recipe sequencing, and SECS/GEM communication for factory integration.
- Software: It uses an intuitive software interface, often supplemented by the advanced Apex analysis software suite for sophisticated data processing, filtering, and customized reporting that complies with industry standards like ISO and ASME.
Applications:
KLA Tencor P-7 is widely used in R&D and production environments for applications such as:
- Quantifying material removal or deposition in etch, sputter, and CMP processes.
- Measuring the depth of etched trenches and SIMS craters.
- Characterizing the topography of defects such as scratches.
- Analyzing wafer bow and shape in semiconductor and compound semiconductor manufacturing.
- Measuring surface texture for various general purpose, biomedical, and consumer electronics applications.


Description: The Bruker Dektak XT Stylus Profiler is a high-performance metrology tool designed for highly repeatable and accurate measurement of surface topography, including step heights, roughness, and waviness. It uses a single-arch system architecture to enhance rigidity and reduce environmental noise, enabling angstrom-level repeatability.
Features:
- Measurement Principle: The system employs a diamond-tipped stylus that physically traverses the sample surface. A Linear Variable Differential Transformer (LVDT) sensor detects vertical deflections, which are then converted into a digital surface profile.
- High Repeatability: A key feature is its exceptional step height repeatability, often cited as 4Å (1 sigma on a 1 µm step), which is a result of its stable, low-noise design.
- Vertical Range and Resolution: It offers a large vertical measurement range of up to 1 mm, with a high vertical resolution that can reach 0.1 nm in certain ranges.
- Variable Stylus Force: The force applied by the stylus can be adjusted from 0.03 mg (with the optional N-Lite+ low force sensor) to 15 mg, allowing measurements on both hard and delicate surfaces without damage.
- Scan Capabilities: It can perform single 2D scans up to 55 mm in length or create large 3D topological maps across an entire 200 mm wafer using scan stitching capabilities.
- Software and Automation: The system is controlled by the powerful 64-bit Vision64 software, which features an intuitive interface, automated multi-site measurement routines, pattern recognition, and extensive data analysis tools for customized reports
Applications:
Dektak XT is a versatile tool used in various fields for quality assurance and research:
- Thin/Thick Film Measurement: Accurately measures the thickness of deposited or etched films.
- Surface Roughness & Waviness: Quantifies 2D and 3D surface textures according to industry standards.
- Film Stress Analysis: Determines residual stress in thin films by measuring the substrate’s curvature change (bow).
- Microfluidics & MEMS: Capable of measuring large vertical features (up to 1 mm tall) in micro-electromechanical systems and microfluidic channels.
- Solar Trace Analysis: Measures the critical dimensions (height, width) of conductive lines on solar panels to ensure manufacturing efficiency.
Tool: Optical microscope Olympus MX51
Description: The Olympus MX51 is a robust, industrial-grade optical microscope designed for reflected-light inspection of electronic parts, metals, plastics, and wafers, featuring Brightfield/Darkfield/Fluorescence capabilities, UIS Optics (Universal Infinity System), a large stage, and modular design for customization, offering ease of use with Frontal Control and high-quality imaging for diverse manufacturing and R&D needs.
Features:
- Application Versatility: Ideal for semiconductor inspection, mold analysis, PCB inspection, and general material science.
- Illumination Modes: Configurable for Brightfield (basic imaging) and Darkfield (enhanced surface contrast). Some advanced versions (MX51-F) also support Phase Contrast and Fluorescence.
- Optics: Utilizes Olympus’s high-quality UIS (Universal Infinity System) optics for sharp, aberration-free images.
- Ergonomics: Features a comfortable viewing head and simple, intuitive controls (Frontal Control system) for efficient operation.
- Modularity: A flexible design allows for various upgrades, cameras, and objectives to suit specific tasks.

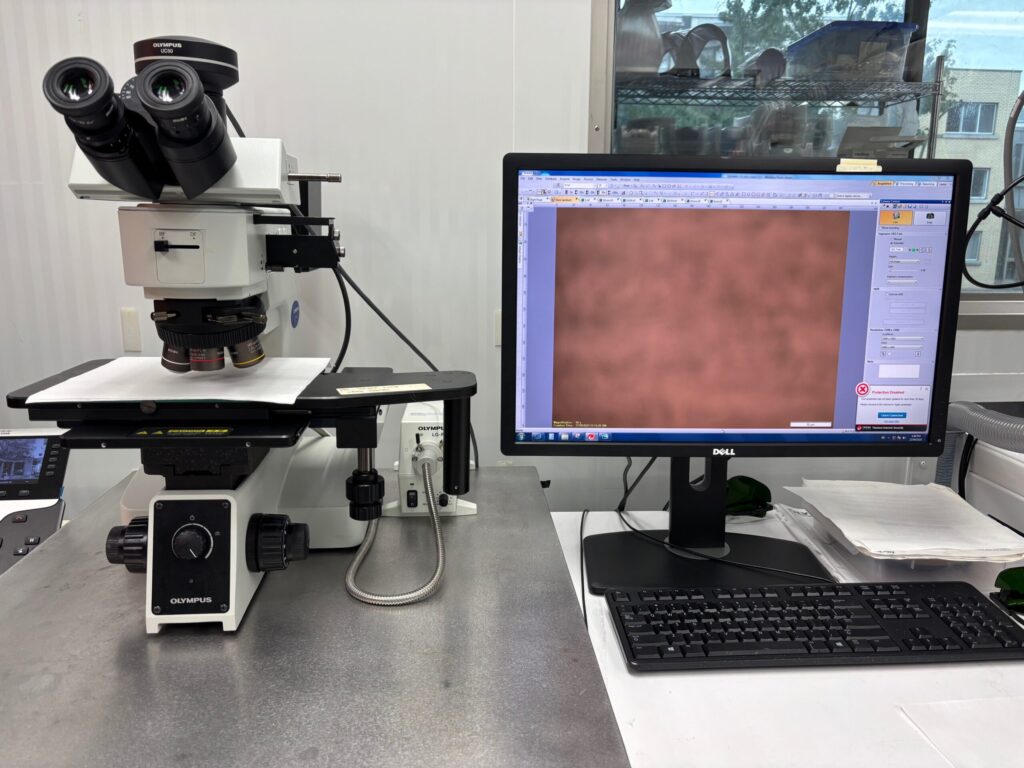

Description: The Nanometrics NanoSpec Reflectometer is a non-contact, optical metrology tool widely used in semiconductor and nanofabrication facilities to measure the thickness of transparent or semi-transparent thin films deposited on reflective substrates, typically silicon wafers.
Principle of Operation
The NanoSpec system operates based on spectroscopic reflectometry and the principle of light interference.
- A focused beam of light (from a halogen or deuterium lamp) is directed onto the film surface over a range of wavelengths (typically in the visible spectrum, e.g., 370 nm to 800 nm).
- Light reflects from both the top surface of the film and the film/substrate interface.
- These two reflected light beams interfere with each other, creating a unique interference pattern (a sinusoidal wave of intensity vs. wavelength) that depends on the film’s thickness and refractive index.
- A built-in spectrometer and detector measure the intensity of the reflected light across the spectrum.
- Using established optical constant values (Cauchy coefficients) for the specific film material and substrate, the system’s software analyzes the interference pattern to calculate the film thickness and sometimes its refractive index.
Features:
- Non-Contact Measurement: The optical, non-destructive method ensures no damage to the sample or film surface.
- Wide Thickness Range: Depending on the model, it can typically measure films from less than 100 Å (10 nm) up to several tens of microns (e.g., 50 µm or 500,000 Å).
- Small Measurement Spot: Various objective lenses (e.g., 5x, 10x, 50x) allow for small measurement spot sizes (down to 5 µm in diameter), enabling measurements on patterned wafers within small features or bond pads.
- Automated Film Thickness (AFT): Many systems (e.g., AFT 2100, 3000, 6100 series) feature automation for rapid, repeatable measurements and the generation of film thickness uniformity maps across a wafer.
- Multiple Film Types: Pre-configured programs allow for measuring common materials like silicon dioxide, silicon nitride, photoresist, and polysilicon on silicon substrates.
Applications:
The NanoSpec is primarily used in micro- and nanofabrication for quality control and process monitoring, including:
- Measuring deposited or etched film thicknesses in semiconductor manufacturing.
- Characterizing photoresist thickness during lithography processes.
- Monitoring film uniformity across a wafer.
- Analyzing the thickness of dielectric layers for various microelectronic devices
Description: The NanoCalc reflectometer is a spectroscopic reflectometry system used for the fast, non-destructive measurement of thin film thickness and optical properties (refractive index n and absorption coefficient k). Manufactured by companies such as Ocean Optics (now Ocean Insight) and Mikropack (now part of KaPaTek), it is widely used in semiconductor, optics, and materials science applications.
Features:
- Measurement Principle: The system measures the intensity of light reflected (or transmitted) from a thin film over a range of wavelengths (e.g., UV, visible, NIR) at a normal (90°) angle of incidence. Interference patterns in the reflected light are analyzed by the software to calculate film properties.
- Non-Destructive Measurement: As an optical technique, it does not require physical contact with the sample (unlike a stylus profiler) or any special sample preparation, making it ideal for delicate materials or in-situ/on-line process control.
- Broad Range & High Resolution: It can measure optical layers ranging in thickness from a few nanometers (as low as 1 nm) up to hundreds of micrometers (~250 µm or more, depending on configuration) with a high resolution of typically 0.1 nm.
- Material Versatility: The system can analyze transparent or semi-transparent films and substrates, including oxides (SiO₂), nitrides (SiNₓ), photoresists, polymers, and even rough materials or metallic layers.
- Software Capabilities: The accompanying software (such as NanoCalc 5.0 or Vision64) includes extensive libraries of material n and k values and uses simulation algorithms to analyze single-layer or multi-layer film stacks (up to 10 layers in some full versions).
- Automation Options: It offers various accessories, including micro-spot objectives for measuring very small areas and automated X-Y mapping stages (up to 300 mm diameter) for creating 2D and 3D thickness profiles.
Applications:
- Semiconductor Manufacturing: Measuring the thickness of critical process films like photoresists, silicon oxides, and nitrides.
- Optical Coatings: Characterizing anti-reflection, anti-scratch, or hard coatings on materials like glass, steel, and plastics.
- Research and Development: Determining material properties for R&D in microfluidics, MEMS, and solar panel development.
- Process Monitoring: Used for in-situ, on-line thickness measurements and monitoring film removal rates during etching or polishing processes
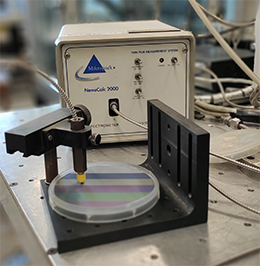

Description: FEI Quanta 450 FEG is an advanced Environmental Scanning Electron Microscope (ESEM) that uses a Field Emission Gun (FEG) for high-resolution imaging and analysis of a wide variety of materials.
Features:
- Imaging Modes: The primary feature is its versatility, offering three imaging modes that allow investigation of both traditional and non-traditional samples without extensive preparation:
- High Vacuum (HV) Mode: Standard SEM mode for high-resolution imaging and analysis of conductive, dry samples, often requiring a conductive coating.
- Low Vacuum (LV) Mode: Enables imaging of non-conductive or outgassing samples without the need for a conductive coating, minimizing thermal damage.
- Environmental SEM (ESEM) Mode: Allows for the imaging of wet, biological, or volatile samples in their natural, hydrated state (at room temperature), by maintaining a specific water vapor pressure in the chamber.
- High Resolution: The thermally assisted field emission gun (FEG) delivers a high-brightness, coherent electron beam, enabling resolutions down to approximately 1.0 nm at 30 kV.
- Detectors and Analysis: The system is equipped with multiple detectors for comprehensive material characterization, including:
- Secondary Electron (SE) detectors for surface topography.
- Backscattered Electron (BSE) detectors for compositional and topographical information.
- Optional analytical systems like Energy Dispersive Spectroscopy (EDS) for elemental analysis and Electron Backscatter Diffraction (EBSD) for crystallographic information.
- User Interface: It features an intuitive “point and click” user interface and motorized stage for easy navigation across large samples.
Applications
FEI Quanta 450 FEG is used across various scientific and industrial fields for surface characterization of a wide range of materials, including:
- Metals and alloys
- Polymers and composites
- Biological samples (plant materials, tissues)
- Geological samples
- Nanoparticles and thin films.
Description: Everbeing offers several configurations of four-point probe systems and modular probe stations used for determining sheet resistance, resistivity, and conductivity of semiconductor wafers or thin films. These systems utilize four co-linear, spring-loaded probes in a “Kelvin” sensing arrangement to eliminate lead and contact resistance.
Features
- Measurement Capabilities: Used for sheet and slice resistivity, doping quality, metallization thickness, P/N typing, and V/I measurements.
- Probing Method: Employs four co-linear, spring-loaded tungsten carbide probes that maintain constant spacing for repeatable results.
- External Integration: Typically requires an external Source Measure Unit (SMU) or a separate current source and voltmeter to operate.
- Chuck Options: Available in stainless steel, gold-plated, or Teflon, with sizes ranging from 2″ to 12″. Vacuum and heated chucks are available as upgrades.
- Microscope Support: Can be equipped with monozoom or trinocular microscopes, offering magnification up to 1650X for precise probe placement.
- Micropositioners: Features high-resolution linear X-Y-Z travel (down to 0.3 μm) with magnetic or vacuum bases to prevent movement during testing.
- Connectivity: Support for various connectors, including 4mm Banana plugs, BNC, or Triaxial female adapters for low-leakage measurements.
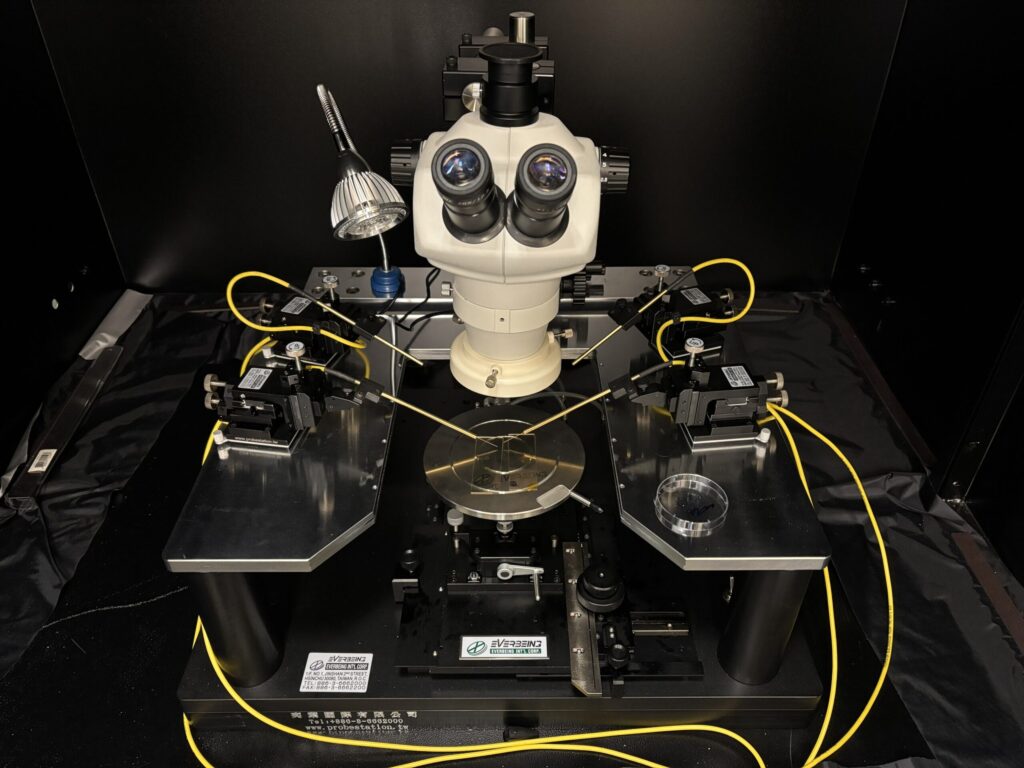


Leave a Reply