
Tool: High Density Plasma Treatment System, Nanoplas Model DSB 600
Description:The Nanoplas Model DSB 600 (also referred to in literature as DSB 6000 Boost) is a high-density plasma treatment system used in microfabrication for material processing, specifically designed for stripping photoresist, descumming, and removing polymers. It is a system commonly found in university and research nanofabrication facilities.
Features:
- Function: Advanced plasma cleaning, primarily for photoresist stripping (ashing), descumming, and polymer removal.
- Applications: Commonly used in MEMS (Micro-Electro-Mechanical Systems) applications and general semiconductor fabrication for processes like opening vias and pads by oxygen plasma etching.
- Processing Capacity: Capable of batch processing up to 25 wafers (150mm diameter) or single-wafer processing up to 200mm.
- Power Source: Features a 600W ICP (Inductively Coupled Plasma) source operating at 13.56MHz. The DSB 6000 Boost model can use up to 800 W of RF power.
- Temperature Control: The system includes a heated quartz chamber (up to 180°C) and a single-wafer stage with heating capability up to 250°C.
- Control Interface: Utilizes PLC (Programmable Logic Controller) control with a touch-screen interface for recipe-driven operation and data logging.
- Chamber Conditions: The process is a dry process that typically uses an external vacuum pump and specific gas flows (e.g., O2 flow rate of 100 sccm).
Description:The Applied Materials AM5000 RIE (Reactive Ion Etching) system is a highly versatile, older-generation semiconductor processing tool used for dry etching of various materials in micro- and nanofabrication facilities. It is often part of the larger Applied Materials Precision 5000 (P5000) platform, which is a modular, load-locked system that can be configured with multiple process chambers for different applications, including both etching and deposition.
Features:
- Process Type: The P5000 typically uses magnetically enhanced reactive ion etching (MERIE) technology, which utilizes a plasma to anisotropically etch materials with precision.
- Modularity: The system is renowned for its modular design, allowing different process chambers (e.g., Chamber A, B, C) to be configured for specific uses, such as metal etching, silicon etching, or dielectric etching.
- Applications: The AM5000/P5000 is used in academic and research labs for general-purpose plasma etching of materials like silicon dioxide, silicon nitride, polysilicon, and various metals.
- Gases Used: Common process gases include chlorine (Cl₂), carbon tetrafluoride (CF₄), trifluoromethane (CHF₃), sulfur hexafluoride (SF₆), oxygen (O₂), argon (Ar), and hydrogen bromide (HBr).
- Wafer Size: Systems are typically configured to process 6-inch (150mm) wafers, with smaller samples requiring mounting onto a carrier wafer.
- Endpoint Detection: The system can incorporate an optical emission spectroscopy (OES) system for endpoint detection, which helps determine when the etching process is complete if enough material is exposed.


Description:The Oxford Instruments PlasmaPro 100 Estrelas DRIVE is a high-performance, flexible plasma etch tool designed for Deep Reactive Ion Etching (DRIE) applications in research and volume production environments. It is primarily used in the fields of Micro Electromechanical Systems (MEMS), advanced packaging, and nanotechnology.
Features:
- Deep Reactive Ion Etching (DRIE): The system specializes in creating deep, steep-sided holes and trenches in substrates, offering highly anisotropic (vertical) profiles.
- Process Flexibility: It is designed to run both the high-rate Bosch™ process (which alternates etching and passivation steps) and the high-precision cryogenic etch technology in the same chamber, without requiring hardware changes.
- Substrate Compatibility: The system is compatible with a range of substrate sizes, from 50mm up to 200mm wafers.
- High Performance: It delivers high etch rates, high selectivity to masking materials, smooth sidewalls, and high aspect ratio processes.
- Advanced Control: Features include fast-acting mass flow controllers (MFCs), high-density plasma sources, automatic pressure control, and the X20 Control System for enhanced reproducibility and reliability.
- Hardware Options: It can be configured with a semi-automatic loading system, mechanical or electrostatic wafer clamping, and optional accessories like a liquid nitrogen auto-changeover unit for temperature control.
Typical Applications
The PlasmaPro 100 Estrelas is used across a wide range of applications, including:
- MEMS device fabrication
- Advanced packaging and through-silicon vias (TSVs)
- Nanostructure and microstructure realization
- Silicon-on-insulator (SOI) etching
- Tapered via etches and high-rate cavity etches
Description: The Plasma-Therm Apex SLR is a versatile Inductively Coupled Plasma-Reactive Ion Etching (ICP-RIE) system used in microfabrication for precise nanoscale etching of various materials like III-V semiconductors, silicon, dielectrics, and polymers, featuring decoupled plasma density (ICP) and ion energy (CCP) control for high etch rates, load-lock transfer for cleanliness, He backside cooling, and flexibility for different wafer sizes (up to 150mm) and chemistries (Cl, F, etc.) for applications in MEMS, photonics, and advanced research.
Features:
- High-Density Plasma: Uses an ICP source (e.g., 2 MHz, 1kW) for dense plasma and a separate CCP source (e.g., 13.56 MHz, 300W) for substrate bias, enabling independent control over ion flux and energy.
- Material Versatility: Capable of etching Si, SiO₂, SiNₓ, metals (Cr), polymers (photoresist, polyimide), and compound semiconductors (GaN, etc.).
- Process Gases: Supports various chemistries, including Cl₂, BCl₃, O₂, Ar, CH₄, H₂, CF₄, CHF₃, HBr, and SF₆.
- Temperature Control: Features precise substrate temperature control, often with liquid cooling and He backside cooling, crucial for deep silicon etching (DRIE) and maintaining selectivity.
- Wafer Handling: Includes a load lock for maintaining vacuum, allowing processing of different wafer sizes (100mm, 150mm) and small pieces on carrier wafers.
- Endpoint Detection: Often equipped with Optical Emission Spectroscopy (OES) for precise process monitoring and endpoint determination.
Applications:
- Deep Reactive Ion Etching (DRIE) for Si.
- Etching III-V semiconductors for lasers and photodiodes.
- Etching high-k dielectrics.
- MEMS, photonics, solid-state lighting, and general R&D/pilot production

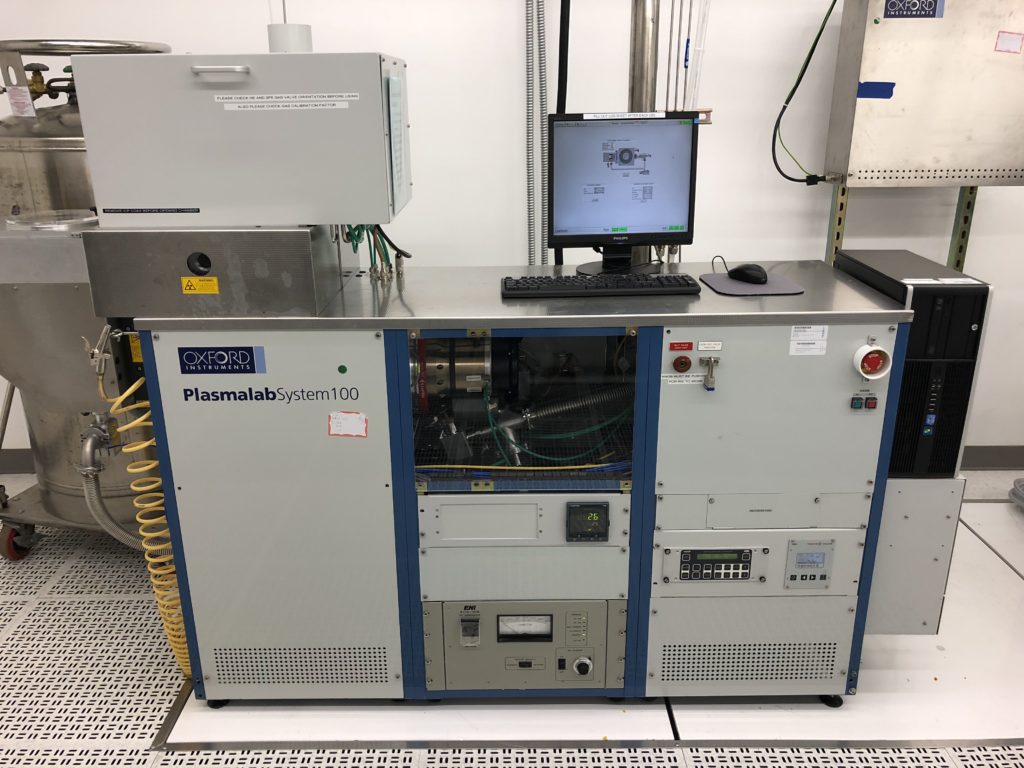
Description: The Oxford Instruments PlasmaPro 100 ICP RIE system is a versatile dry etcher that can be configured to use both fluorine-based (F2) and chlorine-based (Cl2) chemistries, though these chemistries are typically segregated into different, dedicated chambers to prevent cross-contamination.
System Configuration The system allows for independent control of plasma density (via the ICP source) and ion energy (via the RIE source), which is essential for achieving the different requirements of F-based and Cl-based etching.
- F-based (Fluorine) systems are primarily used for deep silicon etching (DRIE), silicon oxide, and silicon nitride using gases like SF6, C4F8, and CHF3.
- Cl-based (Chlorine) systems are dedicated to etching III-V semiconductors (e.g., GaAs, InP, GaN), some metals (e.g., Al, Cr, Pt), and specific dielectric materials using gases like Cl2, BCl3, and HBr.
Features:
- High-Density Plasma: The Cobra ICP source ensures high etch rates and high selectivity.
- Precise Temperature Control: A wide temperature range electrode (-150°C to 400°C) with helium backside cooling is available to manage critical processes like cryogenic etching or high-temperature metal etching.
- Process Flexibility: The modular design of the PlasmaPro 100 series allows for configuration with multiple gas lines (up to 12 or more) to support both chemistries in appropriately dedicated systems.
- Load-Lock System: The standard load-lock minimizes atmospheric contamination and improves process repeatability.
- Endpoint Detection: Equipped with in-situ monitoring tools such as optical emission spectroscopy (OES) and laser interferometry.
Applications:
MEMS, CMOS, deep trench etching (Bosch process), Si photonics.
Optoelectronics (lasers, LEDs), power electronics, metal patterning.


Leave a Reply